




助焊剂也称焊剂,按照形态可以分为固态、液态和膏状三种,比如,松香芯焊锡丝中的松香就是固态的,波峰焊接用的助焊剂就是液态的,焊膏中用的就是膏状的。所谓助焊剂,就是在焊接过程中用于清洁被焊接表面并防止其再次氧化的工艺材料。本章仅介绍液态助焊剂。
液态助焊剂的发展历史主要是由清洗工艺驱动的。在早期的松香基助焊剂中,松香含量很高(通常为20%~40%),大量采用卤素盐的有机化合物作为活化剂。由于该助焊剂残留多且发黏,再加上腐蚀问题,焊接后必须进行清洗。
早期使用的清洗剂为氯氟碳化合物,它们是一种臭氧耗损物质(ODS),最著名的就是氟利昂(CFC),严重破坏臭氧层,最终危害人类安全,因此,在1987年由27个国家发起并签署了《蒙特利尔公约》,要求成员国减少破坏臭氧层物质的排放,最终要求从 1996年1月1日起发达国家全面禁止生产CFC类物质。
后来开发了替代清洗剂——氢氯氟碳化合物(HCFC)和氢氟碳化合物(HFC)。前者仍然含有氯,可能破坏臭氧层,后者是一种温室气体。正是由于溶剂型清洗剂的若干环保问题,水溶性助焊剂应运而生,但又给废水处理带来了难题,最终提出了免洗助焊剂的概念。免洗助焊剂目前已经成为广泛使用的助焊剂种类。
液态助焊剂的发展历程可以用一个简图表示,如图4-1所示。
免洗助焊剂容易引起误解,它本质上是一种低固含量的助焊剂。它的出现有其历史背景,当时元器件引脚间距都比较大,也没有BTC类封装形式,再加上其低的焊剂活性物质残留,在当时的情况下不清洗证明是可以的,因而被称为免洗助焊剂。之所以不用清洗,不是因为焊接后板面残留物少,比较干净,而是因为免洗助焊剂焊后残留物的电气安全性能能够满足要求,不用清洗也不会导致绝缘性能下降或引起腐蚀的问题。而这个相关的评价标准决定了绝缘电阻(Surface Insulation Resistance,SIR)是否满足要求。按照J-STD-004B标准,在IPC-TM-650 2.6.3.7规定的试验条件下(40℃/90%RH、168h、直流12.5V),采用标准的测试板(IPC-B-24),助焊剂残留物的表面绝缘电阻必须大于 10 8 Ω。需要指出,J-STD-004B之前的旧版本J-STD-004,测试方法为IPC-TM-650 2.6.3.3,其试验条件为85℃/85%RH、168h、直流50V。测试条件的变化反映了对SIR的形成机理的认识变化——湿气和游离离子,以及与电化学迁移(ECM)测试的区隔。
需要指出的是,随着元器件引脚间距的不断缩小和BTC类封装的广泛应用,不清洗将面临新的挑战——清洗或者重新设计焊膏配方及制定新的评价方法。

图4-1 液态助焊剂的发展历程
对助焊剂进行分类,主要目的是方便用户选用。
历史上有若干个与助焊剂分类有关的标准,如QQ-S-571E、ISO 9454-1、MIL-F-14256等,其中有些已经废止。目前国际上通用的助焊剂分类标准为IPC J-STD-004B,根据其规定,供应商应当根据助焊剂的组成材料和类型(主要活性水平)进行分类,并按标准的识别代号(Flux Designator)标识。助焊剂的识别代号包含了助焊剂的组成和类型信息。
在IPC J-STD-004B中,首先按照助焊剂不挥发物(固体含量)的主要化学组成将助焊剂分为四大类:松香型(RO)、树脂型(RE)、有机型(OR)和无机型(IN);然后根据助焊剂或助焊剂残留物的腐蚀性或导电性进一步将助焊剂细分为低活性(L)、中等活性(M)和强活性(H)助焊剂,见表4-1。
表4-1 助焊剂分类

续表

而对于历史上曾经使用过的R、RMA、RA、RSA等分类方法,IPC J-STD-004B中也给出了对应关系,见表4-2。免清洗助焊剂可以是RO型、RE型或OR型,但其活性等级肯定是L或M级别的。而水溶性助焊剂一般为OR型,其典型的活性等级为H级别,因此,使用水溶性助焊剂必须进行清洗。
表4-2 助焊剂新旧分类对比

助焊剂类型名称中的0、1分别表示助焊剂中不含卤化物(<0.05%作为不含卤化物的标准)和含卤化物两种状态。L、M、H和0、1都必须由表4-3中对应的测试方法确定,只有满足某类助焊剂的所有测试项要求才能归为某类助焊剂。
表4-3 助焊剂活性分类的测试要求

注:[1] 如果采用免清洗助焊剂组装PCBA,且组装后进行了清洗,清洗后用户应该验证SIR和ECM值。
[2] 测得的助焊剂固体含量中卤化物重量百分比<0.05%时,则该助焊剂视为无卤化物助焊剂。如果清洗后,M0或M1助焊剂通过了SIR测试,而不清洗,则不能通过测试,那么这种助焊剂应当总是进行清洗。
[3] 对于不需要去除的助焊剂,要求只在不清洗状态下进行测试。
液态助焊剂主要由活性剂、成膜物质、添加剂和溶剂组成。
1.活性剂
活性剂也称活化剂,是为提高助焊能力而加入的活性物质,它对焊剂净化焊料和被焊接件表面起主要作用。
活性剂的活性是指它与焊料和被焊接表面氧化物等起化学反应的能力,也反映了清洁金属表面和增强润湿性的能力。润湿性强则焊剂的扩展率高,可焊性就好。在焊剂中活性剂的添加量较少,通常为1%~5%,若为含氯的化合物,其氯含量应控制在 0.2%以下。虽然其添加量少,但在焊接时起很大的作用。不同活性剂其活性大小不同,其作用方式也不尽相同。
(1)对于无机体系焊剂,通常用稀盐酸、磷酸等与金属氧化物作用,形成新的可溶性化合物。
CuO+2HCl→CuCl 2 +H 2 O
3CuO+2H 3 PO 4 →Cu 3 (PO 4 ) 2 +3H 2 O
若用无机盐类,如氯化铵,则可还原金属氧化物或形成金属氯化物。
4MeO+2NH 4 Cl→3Me+MeCl 2 +N 2 +4H 2 O
MeO+2NH 4 Cl→MeCl 2 +2NH 3 +H 2 O
形成的氨可以再分解为氮和氢。氢可使金属氧化物还原。
2NH 3 ↔N 2 +3H 2
MeO+2[H]→Me+H 2 O
被还原和置换出来的活性金属对增强焊料的流动性起很大的作用。它们可以改变液固相接触表面的吸附条件,减小表面张力和表面自由能,增强液固相的润湿和漫流性能,从而起到助焊作用。
(2)对于有机体系,常用有机酸、有机胺等化合物。有机活性剂作用柔和、时间短、腐蚀性小、电气绝缘性好,宜在SMT中使用。有机酸与金属氧化物反应的通式如下:

以硬脂酸为例,其典型反应为:

硬脂酸铜可以在加热时分解,生成活性铜,还可以从其他有机物中取得[H] + ,重新形成硬脂酸。新生成的硬脂酸可再与铜的氧化物作用,使反应周而复始不断进行。
在焊接过程中,有机酸与金属氧化物反应生成有机盐和水,而不稳定的盐受热再分解生成活泼金属,使金属表面裸露,从而达到清洁和助焊作用。
有机胺类活性剂大量是以盐酸盐的形式应用,它们与金属氧化物反应的通式为:

以苯胺盐酸盐为代表的典型反应方程式如下:

CuO+2HCl→CuCl 2 +H 2 O
从上面的反应式可知,任何有机胺、氢卤酸盐在焊接过程中均与金属氧化物反应生成有机胺、金属卤化物和水,达到了去除氧化物的目的。此外,它还可以与被焊金属铜生成活性较大的铜盐或铜的络合物。铜的络合物在焊接加热过程中又分解成活性铜,再与熔融焊料、被焊金属作用,在液固相界面生成活性合金层,改变了表面的物化平衡条件,降低表面自由能,减小表面张力,使焊料与被焊金属相互润湿,增加漫流面积,从而增强了助焊性能。
2.成膜物质
焊剂中加入成膜剂,能在焊接后形成一层紧密的有机膜,保护焊点和基板,使其具有防腐蚀性和优良的电绝缘性。实际上在焊接过程中,成膜剂作为载体,携带活性剂向焊盘周围扩散,协助活性剂提高上锡能力。因此,焊点的饱满与否与成膜剂有较大的关系。
常用的成膜剂有天然树脂、合成树脂及部分有机化合物,如松香及改性松香、酚醛树脂、丙烯酸树脂、改性环氧树脂、氯乙烯树脂、聚氨酯、纤维素、聚乙二醇和硬脂酸酯类等。一般成膜剂的加入量为10%~20%,有的甚至高达40%。加入量过大会影响扩展率,使助焊作用下降,并在PCB上留下过多的残留物。
3.添加剂
添加剂是为了适应焊接工艺和工艺环境的需要而加入的具有特殊物理和化学性能的物质。由于工艺条件及对焊剂本身要求的不同,添加剂的种类及加入量在各种焊剂中也不同。
通常加入的添加剂有pH调节剂和润湿剂、光亮剂、消光剂、缓蚀剂、发泡剂、阻燃剂等。
4.溶剂
波峰焊接使用的是液态焊剂。为此,必须将焊剂组成中的固体或液体成分溶解在溶剂里,使之成为均相溶液。用作焊剂的溶剂应满足以下条件:
● 对焊剂中固体或液体成分均具有良好的溶解性;
● 常温下挥发性适中,在焊接温度下迅速挥发;
● 气味小、毒性小,这也是水基免洗焊剂广泛使用的动力之一。
目前,国内外焊剂中大多采用低级脂肪醇,如乙醇(沸点为78℃)、异丙醇(沸点为82.4℃),有时也加入一些高沸点溶剂配合使用,以改善焊剂成分在溶剂中的溶解度,并调节溶剂的挥发性,这类溶剂也称为助溶剂。
焊接质量的好坏除了与焊料、焊接工艺、元器件和PCB的质量有关外,助焊剂的选择也十分重要。性能良好的助焊剂具有以下作用:
(1)去除被焊接金属表面的氧化物。
必须具有较强的去除氧化物的能力。助焊剂中所含的活性物质能与元器件引线和PCB焊盘表面的金属氧化物发生反应,迅速使焊接表面金属清洁、裸露,使焊料在被焊金属表面具有较强的润湿能力,从而保证焊接质量。
(2)防止焊接时焊料和焊接表面的再氧化。
焊接过程必须加热。一般来说,金属表面随温度的升高氧化程度加剧,无论焊料本身还是被清洁干净的焊接表面都有可能发生再氧化。因此,助焊剂的另一个作用就是在金属表面形成一层薄薄的覆盖层,隔绝空气与金属表面接触,这样就能在加热过程中防止焊料和焊接表面的再氧化。
(3)降低焊料的表面张力,增强润湿性。
助焊剂有降低焊料表面张力的功能,由于助焊剂的存在,改善了焊料与被焊金属之间的相互润湿,起到了助焊作用。助焊剂活性不同,降低焊料表面张力的程度也不同。表4-4列出了不加助焊剂及加不同助焊剂对焊料表面张力的影响。
表4-4 助焊剂对焊料表面张力的影响

(4)有利于热量传递到焊接区。
助焊剂能在焊接过程中迅速传递能量,使被焊金属表面热量传递加快并建立热平衡,不致引起焊接表面及元器件因瞬间受热而损坏,保证良好的焊接过程和焊接质量。
1.树脂型助焊剂
树脂型助焊剂在焊接工艺中的应用已有悠久的历史,在表面组装时代仍被广泛使用。树脂型助焊剂可分成以松香为代表的天然树脂型和合成树脂型两大类,其中最常使用的是松香及其改性树脂。由于松香助焊剂应用较为普遍,通常可将其分成以下几种类型:

无活性松香助焊剂就是将纯松香溶于乙醇或异丙醇等溶剂中组成的助焊剂。它的助焊性能较弱,腐蚀性较小,因此仅能用于易润湿和可焊性比较好的焊接材料。这类助焊剂残留物基本无腐蚀,留在基板上可形成一个保护层,但有时有黏性和吸湿性。一般可不清洗,若清洗也比较容易。
中等活性助焊剂由松香加活性剂组成。活性剂通常为有机酸、有机碱或有机胺盐。活性剂的活性不很强,但可提高助焊性能,对腐蚀性影响也不大。有时有机酸、有机碱或有机胺盐同时使用效果更好。中等活性助焊剂的助焊性能比无活性助焊剂强,残留物腐蚀性比R型大,一般助焊接后需清洗。若所用活性剂中不含卤素或含量极低,采用了活性比普通松香更小的改性树脂作为成膜剂,且组装产品要求又不高,也可不清洗。
活性松香助焊剂与中等活性松香助焊剂相似,也是松香加活性剂,但活性剂比例更高,活性更强,主要用于可焊性较差、氧化严重及对腐蚀性要求不严的场合。由于腐蚀性显著增强,焊接后必须清洗。
2.水溶性助焊剂
水溶性助焊剂是为适应不使用ODS及其他有机溶剂清洗而设计的,最大特点是焊剂组分在水中溶解度大,焊接后残留物可用水清洗。
水溶性助焊剂助焊性能强,对各种材料的适应性较强,助焊接效果优良。但水溶性助焊剂不适合密封不良的器件,如陶瓷滤波器、继电器、微动开关等原件,因为清洗液渗入后难以被完全烘干排除,容易锈蚀电极。
水溶性助焊剂一般分为两类:一类是无机型水溶性助焊剂,另一类是有机型水溶性助焊剂,见表4-5。
表4-5 水溶性助焊剂的分类

水溶性助焊剂由活性剂、成膜剂、添加剂和溶剂组成,但水溶性助焊剂要求助焊剂各组分在水中有一定的溶解度。
水溶性助焊剂的溶剂可以是水,也可以是低级脂肪酸等有机溶剂。以水作为溶剂的水溶性助焊剂对有机组分的溶剂能力弱,随着水分的挥发助焊剂中会出现沉淀;焊接时,若水未挥发干净,在焊料槽中会产生焊料飞溅现象。而以乙醇或异丙醇作为溶剂的水溶性助焊剂则不会出现上述现象。因此,市场上很少有水基的水溶性助焊剂,绝大部分为溶剂型水溶性助焊剂。
3.低固含量免洗助焊剂
免洗助焊剂是指焊接后只含有微量无害助焊剂残留物而不需要清洗组装板的助焊剂。
从保护臭氧层和满足SMT高密度组装的需要出发,采用免洗助焊剂的焊接是解决上述问题最有效的途径。它不仅可免除清洗工艺、省去清洗设备、简化操作、节省人力、降低成本,而且可彻底避免因使用含ODS(臭氧耗损物质)的清洗剂而带来的环境污染问题。
现在使用的免洗助焊剂都是低固含量助焊剂,通常固含量在2%~5%,甚至小于2%。这类低固含量的免洗助焊剂,由于焊后残留物极少,无腐蚀性,具有良好的稳定性,不经清洗即能使产品满足长期使用的要求。
免洗助焊剂都不含卤素活化剂,其活性相对偏弱,因此,预热时间要比传统的松香助焊剂略微长一些,预热温度也要高一些,这些有利于PCBA进入锡波前活化剂能够充分活化。由于低固含量,其防止再氧化能力比较弱,因此,最好在氮气气氛下进行焊接。
1.技术指标与测试方法
助焊剂产品是一种典型的配方型产品,生产工艺并不复杂,产品的技术含量完全在成分的选择与配比上。因此,对于任何一家助焊剂生产商而言,产品配方绝对是公司的最高机密,不可能透露给用户。用户只能从若干技术指标来了解助焊剂的基本性能。
助焊剂的技术指标分为三类:第一类是与基本物理性能相关的,如外观颜色、比重、固体含量;第二类是与助焊性能有关的,如酸值、润湿能力等;第三类是与助焊剂的腐蚀性与电气安全性能相关的,如水萃取电导率、卤素含量、铜镜腐蚀、表面绝缘电阻等。这些技术指标的含义、检测方法及技术指标要求,详情请参见IPC J-STD-004B标准。助焊剂测试方法见表4-6。
表4-6 助焊剂测试方法

注:(o)代表可选项,X代表相关性。
2.外观颜色
从助焊剂的外观颜色很容易区别出是否含有松香。含松香的助焊剂一般呈现淡黄色至棕黄色,有些松香含量高的助焊剂呈棕红色。一般而言,助焊剂在存储期间,特别是在受到阳光照射的存储条件下,颜色会逐渐加深,但是这一般不会影响助焊剂的使用性能。
3.比重
助焊剂的比重即密度,主要取决于助焊剂所采用的溶剂。传统助焊剂的溶剂体系为醇类(如异丙醇或乙醇),故其比重一般为0.80g/mL左右。而新兴的VOC-free助焊剂,其溶剂系统为去离子水,故其比重一般为1.0g/mL左右。
助焊剂的比重与助焊剂的固体含量密切相关。一般而言,固体含量越高,助焊剂的比重越大。例如,一些松香含量在20%~30%的助焊剂,其比重会高达0.83~0.85g/mL。
助焊剂比重的变化与环境温度(不同温度下的比重测量数据都会有偏差)及溶剂的挥发密切相关。在喷雾式波峰焊接工艺中,由于助焊剂存储在一个密闭的槽罐中,溶剂挥发量较小,助焊剂比重变化也很小,故一般不用监测。而在发泡式波峰焊接工艺或者浸焊工艺中,助焊剂暴露于空气中,如果组装车间的温度比较高的话,溶剂的挥发就会相当严重,进而导致助焊剂的比重不断增加。尽管可以通过添加稀释剂的方法来调整助焊剂比重,但是建议在这些应用中最好定期更换助焊剂。因为无论是发泡式涂覆助焊剂还是手工浸沾助焊剂,作业过程中都会不断地将外界的杂质带入助焊剂进而影响助焊剂的品质和助焊能力。
4.固体含量/不挥发物
如同糖水一样,助焊剂的外观是液态,那只不过是一些固态物质已经完全溶解于溶剂罢了(类似于糖溶于水)。助焊剂中的松香和很多种有机活性物质本身都是固态的,而且一些在常温下是液态的有机物在受热完全挥发之后也会有一点固态残余。所有这些都构成了液体助焊剂的固体含量,因为其检测方法是将一定量的液体助焊剂加热至完全挥发干净,称重残余物质进而得到固体含量(具体可参见IPC-TM-650 2.3.34)。
一般而言,助焊剂的固体含量越高,助焊效果就越好。当然这一点不是绝对的,还要看所使用的活性剂的种类,有些活性剂(主要是卤素盐类物质)只需添加千分之几的量就会有很好的助焊效果。
就应用而言,发泡式助焊剂的固体含量一般会比较高,其中主要是松香含量,因为松香自身就有很好的发泡效果;而喷雾式助焊剂的固体含量最好控制在8%以下,否则就会经常堵塞喷嘴。
固体含量高的助焊剂其焊后板面残余物质自然就多,由于国内很多电子制造商特别看重焊后的板面干净程度,所以目前国内流行的助焊剂固体含量在2.0%~7.0%之间。
需要指出的是,上述助焊剂的基本物理性质,如外观颜色、比重、固体含量等并没有标准要求一定要达到某个具体的数据或指标,取舍的判断完全取决于用户的喜好,例如,国内就有一些电子制造商特别喜欢无色透明的助焊剂。
5.酸值
尽管酸或碱均可以与金属表面氧化物发生反应进而起到去除氧化膜的作用,但目前在电子焊接领域使用的助焊剂均为酸性助焊剂(铝合金焊接用助焊剂除外)。简单而言,助焊剂的酸值(acid value)就是中和l克助焊剂中所需要消耗的KOH的毫克数。
酸值从某种程度上反映了助焊剂的助焊能力,即酸值越高,助焊能力越强。就低固含量助焊剂而言,酸值一般在17~35mgKOH/g之间;而高固含量助焊剂,其酸值可能达到50mgKOH/g以上。
液态助焊剂的酸值应当按照IPC-TM-650测试方法2.3.13确定。
6.助焊剂的润湿能力
早期用于助焊剂助焊能力评估的方法是铺展率测试。近年来,更为科学的润湿平衡试验取代了铺展率测试。
助焊剂的润湿能力应当按照IPC-TM-650测试方法2.4.14.2(润湿平衡法)或测试方法2.4.46(铺展测试法)确定。
7.助焊剂的水萃液电导率
就助焊剂的腐蚀性或电气安全性能的检测而言,表面绝缘电阻的测试数据最具有说服力。但表面绝缘电阻的测试耗时长、费用高,并不适合于助焊剂产品在生产过程中的品质监控。
助焊剂产品可能带来的电气安全问题就是降低了焊接后PCB板面(或者说焊点与焊点之间)的绝缘电阻,进而引发漏电现象。这种现象在潮热天气下最有可能发生。因为助焊剂残余吸潮之后,一些导电的离子可能游离出来,形成导电通路。水萃液电导率的数据在某种程度上可以反映这方面的趋势。
水萃液电导率的测试可以由现成的设备完成,目前没有相关的标准对这一检测项目提出具体的数字指标要求。由于这一测试项目简单易行,比较适合生产过程中的品质监控。(注:有些助焊剂酸值不高,但电导率较高,即电阻率较小,使用这些助焊剂时就要考虑其电气安全性能。)
8.铜镜腐蚀测试
助焊剂的腐蚀性应当按照IPC-TM-650测试方法2.3.32(用来确定助焊剂腐蚀性的两种方法中的其中一种)来确定。只有当铜膜没有任何部分被完全除去时,助焊剂才应当被归类为L型。如果有任何铜膜被除去,并可通过玻璃显示的背景证明,此助焊剂就不应当被归为L型。如果只有助焊剂滴周围的铜膜被完全除去(穿透小于50%),那么助焊剂就应当被归为M型。如果铜膜被完全除去(穿透大于50%),助焊剂就应当被归为H型。图4-2为通过铜镜测试所鉴定的助焊剂腐蚀性。

图4-2 通过铜镜测试所鉴定的助焊剂腐蚀性
9.铜板腐蚀测试
此试验用于评估助焊剂残留物在极端环境条件下的耐腐蚀性。试验采用压坑的铜板,在其上放置焊锡颗粒和助焊剂,再流后在40℃、93%RH、240h条件下老化,通过外观腐蚀现象评估助焊剂与焊料合金的相互反应性或腐蚀性,详见IPC-TM-650 2.6.15。为了达到这个测试方法的目的,应当采用下列有关腐蚀的定义:“焊接后并暴露在上述环境条件下,铜、焊料和助焊剂残留物之间发生的化学反应。”按下列要求对腐蚀进行定性评定。
1)无腐蚀
观察不到腐蚀的迹象。因焊接期间加热测试板时,将有可能使初步转变的颜色加深,如图4-3(a)所示,这种状况可忽略。
2)轻微腐蚀
助焊剂残留物中离散的白色或有色斑点,或颜色变为蓝绿色但是没有铜凹陷的现象被看作轻微的腐蚀,如图4-3(b)所示。
3)严重腐蚀
随着蓝绿色污点/腐蚀的扩展,能够观察到铜面板凹陷,则视为严重腐蚀,如图4-3(c)所示。
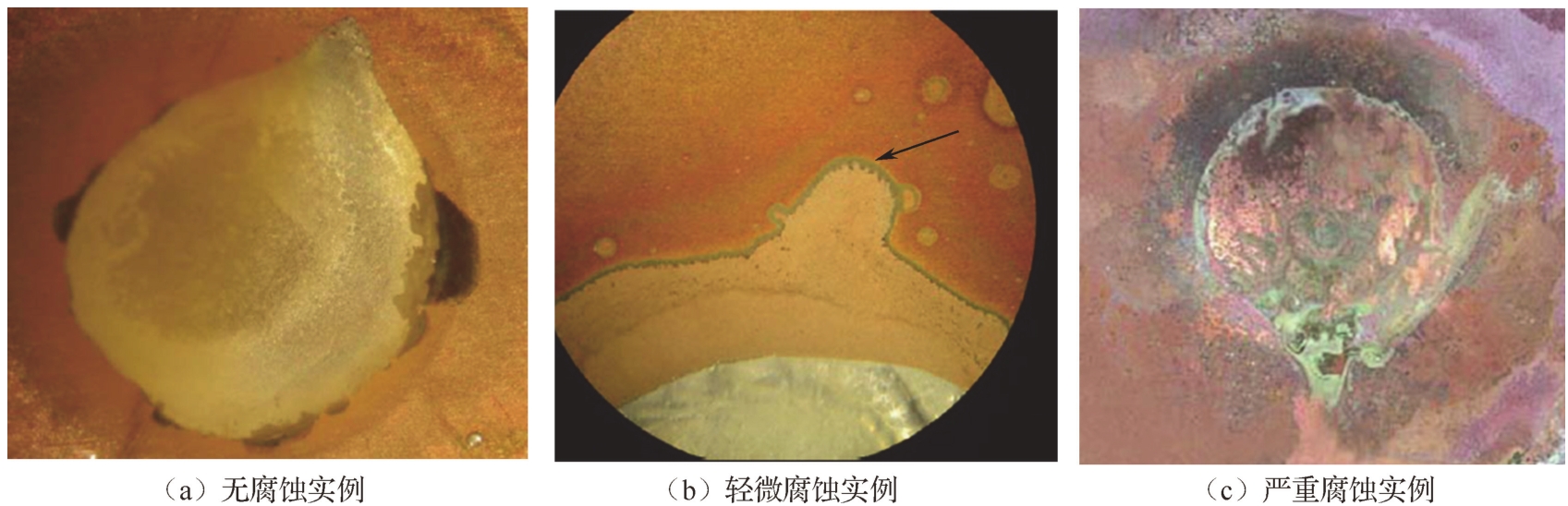
图4-3 板腐蚀测试所鉴定的助焊剂腐蚀性
10.卤化物含量定量测试
对于助焊效果而言,卤化物是一种非常有效的活性剂,早期的助焊剂产品配方中卤化物的存在似乎是不可或缺的。但是卤素离子作为一种活跃的导电离子,其焊后电气安全性能也令人顾虑。因此在早期电子组装作业中,焊后清洗是一个必不可少的工序。现在随着免清洗助焊剂的兴起,越来越多的新型有机化合物被用于助焊剂的配方体系,添加卤素盐的方法已经过时。
助焊剂中卤化物的总含量为Cl - 、Br - 、F - 和I - 测量值的总和。卤化物含量以卤化物在助焊剂固体(非挥发物)成分中的氯化物当量百分比来表示。氯化物、溴化物、氟化物和碘化物的总含量应按照IPC-TM-650测试方法2.3.28.1确定。助焊剂固体含量应按照IPC-TM-650 2.3.34确定。
11.助焊剂表面绝缘电阻测试
表面绝缘电阻(Surface Insulation Resistance,SIR)是关系助焊剂残余电气安全性能的最重要指标。SIR被定义为在特定环境和电气条件下一对接触点、导体或接地装置之间的绝缘材料的电阻值。
SIR的测试,除了测试时间应当为七天外,应按照IPC-TM-650测试方法2.6.3.7来确定助焊剂的SIR要求。SIR图形制备应按照IPC-TM-650测试方法2.6.3.3,采用具体产品的再流焊接或者波峰焊接曲线处理。
说明SIR测试结果时,供应商应当明确指明SIR测试前是否要求清洗及所采用的清洗工艺类型(见IPC J-STD-004B附录A鉴定测试报告)。
通过SIR测试的标准是:
(1)所有测试图形上的所有SIR测量值都应当大于100MΩ。
(2)不应当有使导体间距减少超过20%的电化学迁移(枝晶生长现象)。
(3)不应当有导体腐蚀。梳形电路导体一极有轻微的变色是可以接受的。
需要指出,SIR的测试方法,IPC J-STD-004B与IPC J-STD-004A相比,有很大的不同,见表4-7。
表4-7 IPC J-STD-004A版本与IPC J-STD-004B版本关于SIR测试方法的对比

12.电化学迁移(ECM)测试
电化学迁移(Electrochemical Migration,ECM)测试,是评估助焊剂抵抗电化学能力/腐蚀性的一个重要指标,事关应用环境下的可靠性。在免清洗工艺条件下,助焊剂残留会留在PCB上,特别是那些BTC类器件,甚至填满元器件底部间隙,它会助长ECM。
ECM在IPC J-STD-004B中被定义为在直流偏压影响下导电枝晶的形成和生长,导电枝晶通过含有从阳极溶解出来的金属离子的溶液的电沉积,经电场转移后再沉积至阴极,但不包括由于电场感应所导致的金属在半导体内的移动,和由于金属腐蚀所造成的生成物的扩散现象。由于电化学腐蚀表现为枝晶生长现象,因此,有时也称之为枝晶生长。
ECM的测试应当按照IPC-TM-650测试方法2.6.14.1的方法进行,测试温度为65±2℃,相对湿度为88.5%±3.5%RH,激发偏压直流10V。应当按照IPC-TM-650测试方法2.6.3.3,采用具体产品的再流焊接或者波峰焊接曲线制备ECM(电化学迁移)测试图形。
1)测试用梳妆图形
应当采用IPC-B-25(B或E图形)或IPC-B-25A(D图形)试验板,梳妆图形的导线宽度和间距必须是0.318mm,测试图形为未经处理的裸铜,图4-4为IPC-B-25A测试板。

图4-4 IPC-B-25A测试板
D图形与IPC-B-25B或E图形相同。在进行工艺评估时,应使用与实际使用PCB相同的基板材料和制作条件。
2)测试板准备/制作
(1)测试板准备之前应进行清洗和干燥,以满足在 35℃、最小湿度 85%条件在存放 24h后,所测试的最小绝缘电阻值不小于4×10 10 Ω。
(2)用于评估液态助焊剂。将液态助焊剂涂覆(浸、刷、喷涂均可)到测试图形的整个平面上,以图形横向方向垂直放置1分钟。测试板边缘连接器的手指应受到保护,使其不受助焊剂的影响。采用生产用波峰焊接设备、生产工艺对测试板进行波峰焊接,至少有三个样品。
(3)用于评估焊膏助焊剂。采用与测试图形一致的至少0.20mm厚的钢网印刷焊膏并进行再流焊接。如果发生桥连,则丢弃式样,重新制作。
3)测试方法
(1)将端接的测试样本放入合适的机架中,使样品保持至少2.5cm的距离,气流平行于试验样品梳妆图形的方向。对于硬接线,电线应该放在底部,以防止导线上的助焊剂残留滴落到梳妆图形上,连接1、3和5端口的导线接入限流电阻。
(2)将测试架放到试验箱测试室中心的位置,导线从试验箱线孔拉出来,并远离试样,应确保导线上的冷凝液不要滴落到测试样板上。
(3)关闭箱门并使所有样品在测试温度和湿度下持续放置96h。之后测试初始绝缘电阻,测试电压可以选取直流45~100V。由于极性,测量应该是在端子1和端子2、端子3和端子2、端子3和端子4以及端子5之间进行。
(4)使用限流电阻与测试电路串联,并在测试期间应用直流10V。这个电压是根据一般电路中使用的电压确定的。
(5)在施加偏置500h后(总计596h),断开电源和重复测量。
4)测试结果报告
说明ECM测试结果时,供应商应当明确指明ECM测试前是否要求清洗及所采用的清洗工艺类型。
应当根据测试方法报告绝缘阻抗初始值(IR 初始 ,96h稳定期后的测量值)和绝缘阻抗最终值。通过ECM测试的标准是:
(1)IR 最终 ≥IR 初始 /10,即施加偏压后的平均绝缘阻抗不应当降低至小于绝缘阻抗初始值的1/10。
(2)不应当有使导体间距减少超过20%的电化学迁移(枝晶生长现象)。
(3)不应当有导体腐蚀。梳形电路导体一极有轻微的变色是可以接受的。
13.绝缘电阻(SIR)测试与电化学迁移(ECM)测试的说明
ECM测试与SIR测试,无论是测试样品的准备,还是测试方法,都十分相近,两者测试的都是表面绝缘电阻,用于评价助焊剂的腐蚀性,但其目的有所不同。
ECM测试,主要用于测试电压诱导的金属腐蚀现象,主要腐蚀结果就是枝晶生长。高的测试温度、高的电场强度(直流10V/0.318mm)、长的测试时间,就是为了激发枝晶的生长。而SIR试验主要用于测试电路板上助焊剂残留物的绝缘性,因此,测试条件采用了低温条件,旨在减少较高温度对焊机活性物质的分解(特别是液态助焊剂)。测试期间所加的较低电场强度(直流12.5V/0.5mm)是为了避免低残留免洗焊膏残留物有机极分子极化。较宽的测试图形导线间隔是为了避免枝晶生长超过间隔的20%带来的测试失真。
影响SIR测试结果的因素有以下几种。
1)助焊剂的化学成分
为了对比SIR和ECM测试的有效性,有人研究了助焊剂化学性质对SIR和ECM的影响,得出以下两点结论:
(1)对于低残留免清洗(具有相当低的腐蚀性)的助焊剂,无论SIR还是ECM,测试结果与表征助焊剂属性的助焊剂体电阻率、助焊剂残留物水萃取电阻率、助焊剂残留物水分吸收、没有偏压的助焊剂腐蚀性等无关。
(2)发现SIR和ECM测试的SIR值与助焊剂的pH值有关,但取决于助焊剂类型与测试条件。对于松香助焊剂,SIR和ECM测试的SIR值与助焊剂的pH值是函数关系,这种现象对于SIR的测试更加明显,如图4-5所示。对于低残留免清洗助焊剂,只有SIR测试显示出这样的pH机理,而ECM测试却没有,如图4-6所示。这可能是研究采用的激发偏压不同所致,该研究中SIR测试采用的是50V直流偏压,ECM是12.5V直流偏压。高的偏压诱发了有机分子极化。

图4-5 松香助焊剂的pH值对SIR和ECM的影响
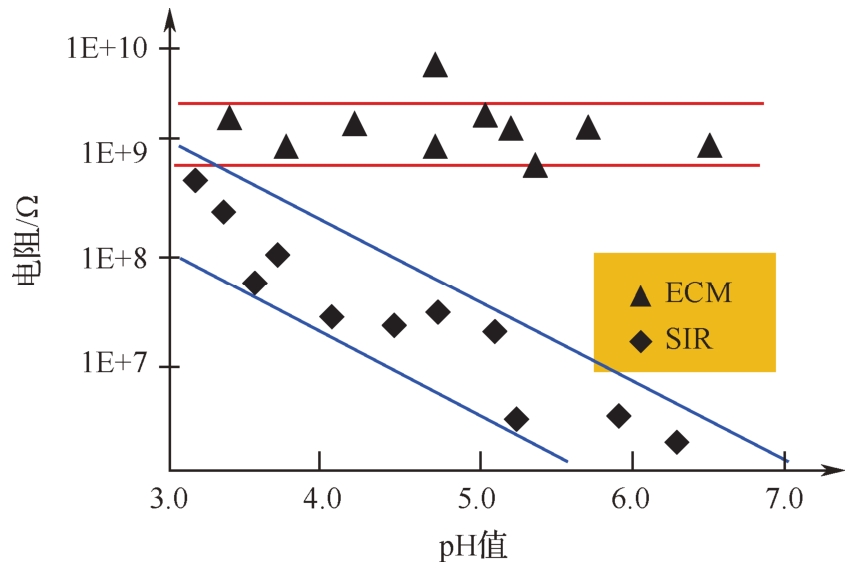
图4-6 低残留免洗助焊剂的pH值对SIR和ECM的影响
2)测试条件
(1)测试温度。测试温度会影响金属腐蚀速度,大概因为这个原因,IPC J-STD-004B把SIR的测试条件中的温度由85℃改为40℃,以反映助焊剂残留物本身的绝缘性能。
(2)诱发偏压。诱发偏压会影响失效机理,电压越高,电解诱发的离子越多。大概因为这个原因,IPC J-STD-004B把SIR的测试条件中的偏压由50V直流电压改为12.5V直流电压。
(3)再流焊接温度。其对SIR和ECM性能有很大的影响。通常低的温度产生低的IR值,这可能形成枝晶结构。一般来说,较低的焊接温度将消耗较少的助焊剂,因此,有更多剩余的助焊剂活性物质留在PCB上。另外,一些溶剂仍将会留在助焊剂残留物里,它会减少残留物抵挡湿气的能力。通常在温度、湿度和偏压的条件下,剩余的助焊剂活性物质常会与电极发生反应,进行电解,或在偏压下迁移,因此产生了较低的IR值或枝晶结构。
随着BTC类器件的广泛使用,经常出现再流焊接后器件底部被助焊剂或溶剂未完全挥发干净填满的情况。在这种情况下,根据标准的方法测试SIR或ECM已经没有多大的意义,应当根据器件实际的导体间隙、偏压和残留物状态设计测试方案,这对产品的实际应用可靠性更有效。如果用于评价焊膏,可以采用标准推荐的梳妆图形,采用实际电路的工作电压作为试验偏压,采用盖玻璃片的方法制造溶剂未完全挥发的“湿”的助焊剂残留物制作测试样品。这样的测试结果更能够反映焊膏的可用性,因为大多数焊膏的设计没有考虑这种应用场景,基本是按照IPC标准设计的。
助焊剂的选型评估分三步进行:(1)根据组装产品可靠性与工艺特性选择合适的类别;(2)可靠性评估;(3)工艺性评估。
市场上的助焊剂通常按照助焊剂的三大属性——活性、固含量和材料类型进行分类。据此通常把助焊剂分为三大类,即低固含量的免清洗助焊剂、松香助焊剂和水溶性助焊剂,如图4-7所示。

图4-7 助焊剂的市场分类
对于液态助焊剂,需要了解以下几点:
(1)固含量与工艺寿命有关。一般而言,如果固含量较高,预热时会承受较高的预热温度和较长的预热时间,也就是工艺寿命比较长,这是因为熔融的成膜物质会覆盖住被焊接表面,具有阻止再次氧化的作用。反之,工艺寿命比较短。这就是水基免洗助焊剂在比较高的温度下表现不佳的原因。
(2)溶剂类型,往往与是否使用松香联系在一起。凡是使用松香的助焊剂,肯定不是水溶性助焊剂或水基助焊剂,因为松香不溶于水。
(3)高含量松香助焊剂和水溶性助焊剂,活性比较强或很强,焊接性能极好,但是,焊剂残留物腐蚀性也很强,所以,焊接后一定要清洗。此类助焊剂可以适应可焊性不好的元器件焊接,提供最好的焊接质量(如最低的虚焊风险)。对于传统的纯松香助焊剂,空气焊接气氛下,其活性取决于松香的含量,如图4-8所示。
(4)水溶性助焊剂,一般都是溶剂型的,水基的很少见到。
(5)免洗助焊剂,不含卤素活化剂,活性很弱。在早期的配方设计中,也是非树脂、非松香型的。目前的免洗助焊剂大多数含有松香,只不过含量比较低,很多在2%以下。

图4-8 纯松香助焊剂固含量与助焊性(焊锡在无氧铜板上润湿性)
工艺性评估,简单地讲就是对助焊剂的应用性进行评估,一般考虑以下几个方面:
● 桥连缺陷率;
● 通孔透锡率;
● 焊盘上锡饱满度;
● 焊后PCB表面洁净度;
● ICT测试直通率;
● 助焊剂残留物表面绝缘电阻。
1.桥连缺陷率
波峰焊接最主要的焊接不良问题是桥连,特别是密脚插装连接器的桥连。桥连现象的产生与PCB的传送方向、引脚热特性、焊盘的设计、引脚的伸出长度等很多因素有关,也与助焊剂的助焊性能有关。因此,通过对典型PCBA进行焊接实测,能够反映助焊剂的综合工艺性能——涂覆性、气味、助焊性能。
试验板可以根据自己公司的产品使用的封装、布局密度进行个性化的设计,一个原则就是能够反映公司产品的难点、工艺能力。图4-9所示是一个波峰焊接试验板示意图,仅作为试验要素说明之用。

图4-9 波峰焊接测试板示意图
密脚插装连接器:
引脚中心距为1.27mm、1.5mm、1.75mm、2.0mm,伸出板面长度为1.5mm,平行于传送方向布局,按照一般的盗锡焊盘设计。
片式电容:
选用0805,封装侧面间距为:0.35mm、0.45mm、0.55mm、0.80mm、1.0mm、1.2mm、1.4mm。
插件焊盘到片式元件焊盘间距为:0.6mm、0.8mm、1.0mm、1.2mm。
2.通孔透锡率
通孔透锡率在很大程度上取决于设计,但是透锡率在某种程度上也反映了助焊剂的润湿能力。波峰焊接时,焊料要从焊接面开始润湿元器件引脚和通孔的覆铜层,进而爬升并填充整个通孔,最后在元器件面也可以形成焊点。IPC J-STD-001和IPC-A-610D标准中均规定75%的通孔填充率(如图4-10所示)是最低要求,这里,我们必须清楚,不同板厚即使透锡率一样,实际的焊缝高度也是不同的,因此,应根据自己的产品确定合理的透锡率。
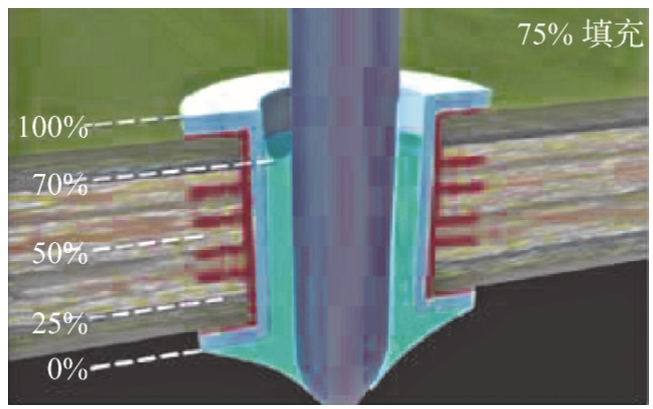
图4-10 通孔填锡的要求
3.焊盘上锡饱满度
上锡饱满度主要包括两个方面:(1)焊料在焊盘上的覆盖面积;(2)焊点饱满程度,即上锡量的多少。就覆盖面积而言,100%的覆盖率当然是最理想的,但是,有少量露铜也是允许的,如图4-11所示。这两张图片是IPC-A-610D标准中给出的可以接受的焊盘覆盖面积的范例。事实上,IPC J-STD-001和IPC-A-610D标准中均规定75%的焊盘覆盖率是最低要求。而焊点饱满程度的评估比较复杂,如片式元件涉及焊缝高度、宽度、长度等,如图4-12所示。需要指出的是,波峰焊接的片式元件采用的是红胶工艺,焊点宽度与贴片有很大关系。

图4-11 焊盘覆盖率
4.焊后PCB表面洁净度
如图4-13所示的目视干净的PCBA板面肯定是用户最希望的。但是在免清洗工艺广为采用的今天,要得到非常干净的焊后PCB表面是非常困难的。焊后PCB表面上助焊剂残余物的存在是不可避免的,问题就在于如何界定清洁度。如果是类似于图4-14所示的目视比较“脏”的PCBA板面,存在明显的腐蚀痕迹或者助焊剂残余物集聚,那么肉眼观察即可判断NG(不合格)。而大多数情况是介于上述两者之间的,这时就需要依靠试验来检验清洁度。
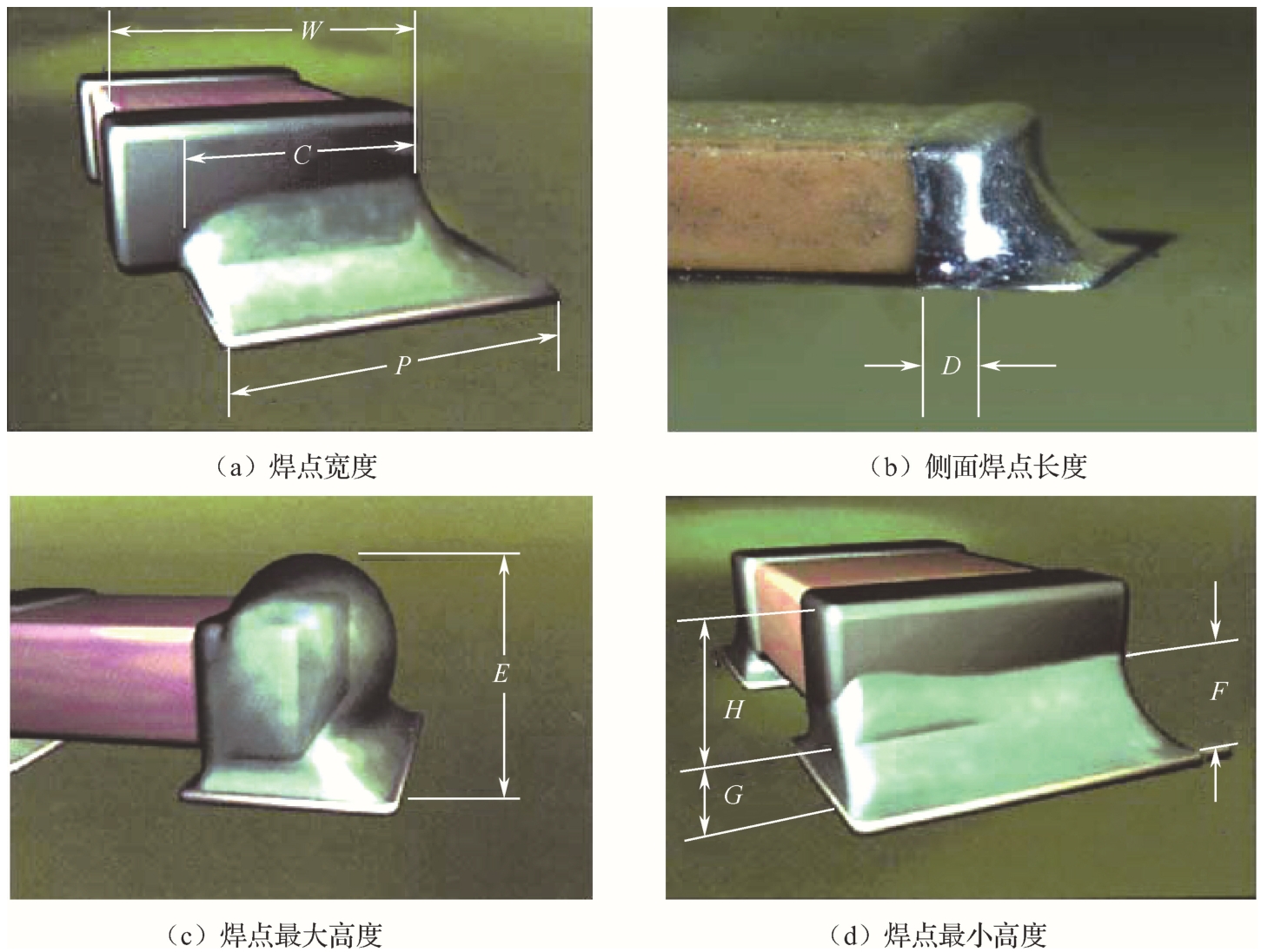
图4-12 片式元件焊点饱满度要求

图4-13 目视干净的PCBA板面(局部)

图4-14 目视比较“脏”的PCBA板面
板面清洁度的评价方法主要有两种:(1)SIR测试;(2)离子污染测试。如同前面在论述免清洗的定义时所讲,助焊剂残余物是否需要清洗,最根本的判据在于其是否会影响电气安全性能,而SIR测试就是最有效的试验手段。离子污染测试的基本原理是测量板面助焊剂残余物的萃取液的电阻率,标准判据是离子污染值不可以大于1.56g NaCl当量/cm 2 ),具体可参见IPC-TM-650 2.4.25。
在免清洗工艺中,有一种如图4-15所示的白色残余物十分常见。

图4-15 免清洗工艺常见的白色残余物
5.ICT测试直通率
在线测试(In-Circuit Test,ICT)是很多电子产品制造商喜欢采用的一种产品电气性能测试方法。一般做法为在PCB上预留一些专门用于ICT测试的小焊盘,焊接完成之后,让ICT测试设备的探针与测试点接触来测试整个组装件是否能实现预定的电信号传输功能。在ICT测试过程中,探针与焊点的良好接触是准确测试的前提条件。如果测试点上的助焊剂残余物对于接触存在随机的阻碍作用,将造成误判。因此,需要进行ICT测试的电子产品制造商对于ICT测试直通率(反之为误判率)均有自己的标准要求,一般应在95%以上(误判率为5%以下)。
ICT测试直通率与助焊剂配方有密切关系,因为不同配方条件下助焊剂残余物的性质不同,是否会阻碍探针与测试点的接触也会随之不同。
6.助焊剂的多元化
助焊剂产品与焊料合金产品在应用上的最大不同在于普遍适用性的差别。就焊料合金而言,无论是什么样的电子产品,Sn-37Pb焊料合金或者无铅的Sn-Ag-Cu合金都是适用的。而助焊剂则不同,哪怕是同一种电子产品,不同的制造商也会对助焊剂有不同的要求。这也造就了助焊剂产品的多元化,一个成熟的助焊剂产品供应商一般都有几十种甚至上百种的助焊剂产品供客户选择。
举例来说,一般的电子产品制造商都希望得到光亮的焊点,焊点外观的光泽度甚至被作为评价所使用的焊料合金纯度的一种方法。但是,在一些PCB面积比较大、板上焊点比较多的情况下,制造商会要求采用消光型助焊剂,即所得到的焊点为亚光型。这主要是因为在后续焊点质量的目视检测过程中,如果焊点多且光亮,很容易造成工人的视觉疲劳。因此,消光型助焊剂作为一类特殊用途的助焊剂也占据了一定的市场份额,最主要的用户就是电视机生产商。
正因为助焊剂的多元化特点,在选择或者销售助焊剂的时候,就必须弄清楚真正的需求,这样才会缩短试样的时间,尽可能快地满足客户实际应用的需求。一般而言,下列问题是必须考虑的:
● 助焊剂涂覆方式。浸沾、发泡还是喷雾?
● 焊接方式。浸焊、单波峰焊接还是双波峰焊接?
● 免清洗、溶剂清洗还是水清洗?
● 单面焊还是双面焊(需要贯穿通孔)?
● 是否存在ICT测试工序?
● 波峰焊接之前经过几次再流焊接?
● 有铅工艺还是无铅工艺?
● 与PCB阻焊层及三防材料的兼容性如何?
● 客户对现用助焊剂的最大抱怨是什么?是桥连多、空焊多、板面不干净、ICT测试误判率高、通孔贯穿不良、SIR偏低还是漏电、上锡不饱满等?
印制电路板焊接后可能出现白色残留物,由于其出现的多样性、突然性,一直是业界的一个困扰。有的是在清洗后出现白色残留物,如图4-16(a)所示;有的是免清洗的板子在储存后出现白色残留物,如图4-16(b)所示;也有的在使用过程中由于返修而发现部分焊点出现白色残留物,如图4-16(c)所示。

图4-16 白色残留物
IPC规定:除非能证明这些白色残留物是可靠的,否则就拒收。而实际情况是,由于外观原因,客户一般都是拒收的。那么这些白色残留物为什么会突然出现?有没有可靠性的问题?虽然PCB制造所涉及的化学成分众多,各厂家使用的材料不一,但从化学的角度讲,其反应的机理仍有相通性。白色残留物的成分和可能的产生原因有以下几种。
大多数清洗不干净、储存后、焊点失效后产生的白色残留物,其主要成分都是助焊剂中本身固有的松香。松香通常是一种透明而硬脆的无定形固态物质,无定形物质与结晶体相比通常保留着过量的内能,称为热力学上的不稳定状态,因此松香有结晶的趋向。引起松香结晶,由无色透明变为白色粉末的主要原因如下:
1)松香本身化合物的结构
树脂酸异构体的比例对松香的结晶趋势有较大影响。此外,中性物质的含量对松香的结晶趋势、软化点有一定影响,中性物质越多,结晶趋势越小。由于清洗不干净造成的白色残留其主要物质就是松香在溶剂挥发后形成的结晶粉末。图4-17 为某背板,就是因为手工清洗不干净导致松香结晶变成白色的实际工程案例,分析表明白色残留物仍然为助焊剂残留物松香。
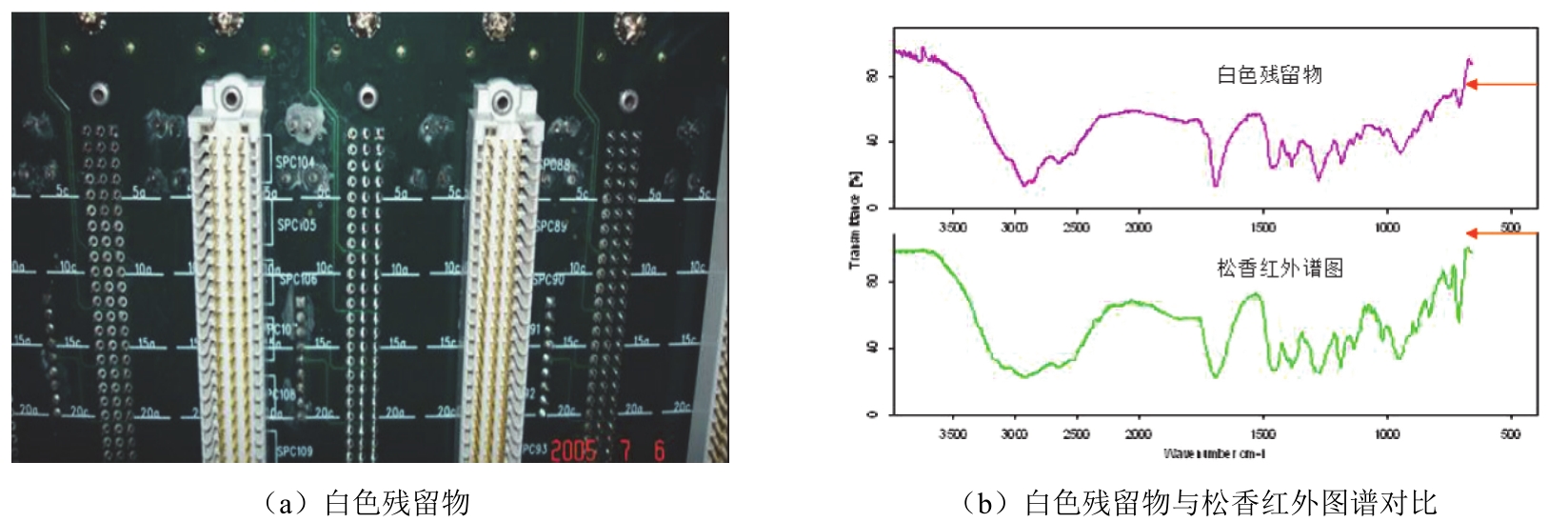
图4-17 清洗不干净导致的白色残留物现象
2)松香中的水分
除松香本身的原因外,水分对松香的结晶也有很大影响。松香本身有一定的吸湿性,树脂酸可在水分表面定向,形成结晶条件。一般认为,水分含量在0.15%以上的松香易形成结晶。当PCB在高湿条件下储存,吸收的水分达到一定程度时,松香就会逐渐从无色透明的玻璃态向结晶态转变,从视觉上看就是形成白色粉末。这也是为什么同一张PCB在储存后,免清洗助焊剂部分、锡丝补焊部分可能形成白色粉末残留,而免清洗锡膏残留尚未见形成白色粉末残留的原因。其主要原因就是免清洗锡膏残留的松香较之前两者要多很多,而表面积又相对较小,吸收的水分不足以引起结晶。
3)其他原因
当松香中有溶于其中的其他物质的晶体时,在松香的结晶趋势变大时,这些物质就成为晶种引起松香结晶。在PCB再流焊接或波峰焊接中,如果助焊剂、PCB、零部件中的化学物质反应生成了不能溶于液态松香的物质,则在冷却后就成为松香中的晶种,从而加速并促成松香的结晶。
此外,当松香处于结晶的临界状态时,震动也易引起结晶。PCB上的这种白色粉末,究其本质仍是松香,只是形态不同,因此仍具有良好的绝缘性。
松香的化学性质主要取决于树脂酸,树脂酸分子结构有两个活性基团——羧基和共轭双键。松香去除焊接面氧化物的功能就是由羧基完成的。树脂酸中的共轭双键有较高的化学活性,在焊接条件下(高温、有氧)容易发生氧化和聚合反应(高温、有金属离子做催化剂)。这种氧化、聚合产物在常用清洗溶剂中的溶解度小于松香,因此,当采用正确的清洗方法后,PCB上仍有白色残留,大部分的情况下都是这种松香氧化物或聚合物或两者皆有。随着无铅焊接温度的提高,松香氧化、聚合的程度会增加,因此在保证焊点质量的情况下,控制峰值温度和时间也是非常重要的。
PCB的制造过程中会使用很多化学物质,如果由于某种原因导致问题出现,较正常情况下产生更多的化学物质残留,在焊接条件下,这些物质都极有可能与助焊剂发生反应。由于涉及化学物质众多,要对其进行完整、清晰的理解是一件非常困难的事情。曾经出现过的事例之一是PCB的阻焊油墨固化不够,其尚未固化的环氧单体与松香发生反应,如图4-18所示,形成溶解性很差的白色残留物。这类白色残留物属于有机物范畴,仍具有良好的绝缘性。

图4-18 环氧单体与松香发生反应
有机酸与金属氧化物反应生成可溶于松香中的金属盐,从而达到清除焊接表面氧化物的目的,这是助焊化学最主要的反应。
这类有机金属盐一般都可溶于液态松香中,冷却后与松香形成固溶体,在清洗中与松香一起被去除。如果焊接表面、零部件氧化程度较高,则生成的这类物质浓度较高,当松香的氧化程度较高时,则可能随未溶解的松香氧化物留在板上成为白色残留物。这时板上残留物中的离子浓度反较未清洗时高,可靠性也大大降低。在SMT组装中,应慎重选择焊接材料。在清洗制程中,不能选择免清洗的锡膏、助焊剂,否则会因为清洗不完全,降低可靠性。
在酸性条件下,卤离子(F - 、Cl - 、Br - )可以和焊料中的金属氧化物反应生成相应的金属盐。
卤离子的来源如下:
● 助焊剂或锡膏中的含卤活性剂;
● PCB焊盘中的卤离子残留;
● 元器件表面镀层的卤离子残留;
● PCB板材(如FR-4)中含卤材料在高温时释放出卤离子。
这些金属盐在有机溶剂中的溶解度一般较小。如果采用的清洗剂与助焊剂的残留物相匹配,对残留的大多数成分都呈现适当的溶解性,较少的不可溶部分可被大多数可溶解部分“运走”,所有残留物会被完全地消除。然而,如果选择的清洗剂只适合一小部分残留物成分,则“运走”效应并不足以消除所有的残留物,从而产生白斑。某厂使用免清洗锡膏制作了一批板子,后因某种原因需要清洗,在使用清洗剂A后,产生白斑。在与材料供应商协商后,采用清洗剂B。清洗剂B可清洗干净PCB,但对于曾经使用过清洗剂A的板子,再用清洗剂B时,仍然留有白斑,不能完全清洗干净。其实,这就是一个“运走”效应的具体体现。采用清洗剂A清洗后,即便再使用清洗剂B,由于可溶解物质的减少,“运走”能力也会相应大大降低。在环保呼声日渐高涨的今天,清洗制程使用水已成为主流。在水洗制程中出现过工艺条件、材料都没有变化的情况下,其中一批板子出现白斑。经验证主要为碳酸铅化合物。PbCl 2 在水中的溶解度约为1g/100mL,PbCO 3 则几乎不溶于水。一般水洗制程使用的助焊剂和锡膏都含有相当量的卤离子,如果焊接后环境温度、湿度较高,又在焊接完成后较长的时间清洗,则可能生成不溶于水的碳酸铅,从而出现白斑。

大部分物质的溶解度都会随温度的升高而升高,因此在水洗过程中,适当提高水洗温度,一般认为可提高清洗能力。在某工厂曾出现一个事例,在清洗时水温达到了 70℃,焊点在显微镜下可明显观察到上面有白色残留物,如图4-19所示,经化学分析,主要成分为Sn(OH) 4 ,是不溶于水的物质。出现这种现象可能的原因是,在较高的温度下,反应速率增加,从而导致大量的Sn(OH) 4 生成。

图4-19 显微镜下焊点上的白色残留物
白色残留物是否有害,取决于白色残留物是否吸湿和可离子化,在湿气和偏压存在的情况下,是否会有潜在的腐蚀性。
白色残留物趋向于吸湿和导电,这会在敏感电路上潜在地造成电流泄漏和杂散电压失效。助焊剂活性物质在残留物中没有失去活性并一直存在白色残留物中,如果有湿气存在,它们就会分离,导致电化学迁移。
松香是一种透明、有脆性的固体天然树脂,是一种复杂的混合物,由树脂酸(枞酸、海松酸)、少量脂肪酸、松脂酸酐和中性物等组成。松香的主要成分为树脂酸,占总成分的90%左右,分子式为C 19 H 29 COOH。松香外观为淡黄色至淡棕色(如图4-20所示),有玻璃状光泽,带松节油气味。
松香能溶于乙醇、乙醚、丙酮、甲苯、二硫化碳、二氯乙烷、松节油、石油醚、汽油、油类和碱溶液;在汽油中溶解度降低;不溶于冷水,微溶于热水。
松脂加工工序主要有:松脂熔解、净制和蒸馏。先将松脂加热熔解,并加入松节油和水,使松脂呈液态,过滤除去大部分杂质,并洗去深色水溶物;同时,加入脱色剂如草酸,以除去松脂中铁化合物。脂液再用热水洗涤,进入净制工序,以进一步除去细小杂质和绝大部分水,得到的净化脂液在间歇蒸馏锅或连续蒸馏塔中用过热水蒸气蒸馏,蒸出松节油,余下松香。

图4-20 松香
松香属于非晶体,没有固定的熔点(通常是在一个大气压下测试)。由于其是混合物,不同地域产的松香成分不同,熔点也不同,一般在174~200℃。如某款焊膏,通过回流焊接装置对焊膏熔化过程进行观察,可以看到焊膏在 70~80℃开始软化,184℃开始液化,205℃非常的稀,225℃沸腾。
不同松树树种的松香基本上具有相似的化学成分,但是其相对含量有所不同。松香的主要成分是树脂酸,占总质量的85%~90%,它们是一类具有一个三环菲骨架的含有二个双键的一元羧酸,按其双键位置不同,可以分成三大类(如图4-21所示)。
松香的化学反应主要在枞酸型树脂酸分子的两个活性基团——羧基和共轭双键上进行。它的主要反应有:
1)异构反应
具有共轭双键的四种枞酸型树脂遇热或受到无机酸、有机酸的影响时易发生异构化,最后得到枞酸含量高达95%的平衡产物。
2)加成反应
在所有的纯树脂酸中,只有左旋海松酸能以其共轭双键结构与马来酸酐发生狄尔斯-阿德尔反应,生成加成物。其他枞酸型树脂则不与马来酸酐发生反应。但在加热条件下,枞酸、新枞酸、长叶松酸会异构成左旋海松酸。
松香也可以与反丁烯二酸(富马酸)、丙烯酸、β-丙酸内酯等发生加成反应。或与甲醛、乙醛、丙醛、丁醛、苯甲醛、丙烯醛等发生类似的加成反应。此外,松香还可以与苯乙烯、环戊二烯、苯酚等发生反应。
3)氢化反应
枞酸型树脂酸的共轭双键结构在催化剂作用和一定的温度、压力下,部分或全部被氢气所饱和。由于树脂酸中第一对双键易于氢化,第二对双键的氢化则受到抵制,同时,第二对双键对氢化的敏感性也大大降低,因此,氢化常常只进行到二氢阶段。松香的加氢反应可以使其结构趋于稳定,消除因共轭双键而引起的易于氧化变色的缺点。

图4-21 松香异构体
4)歧化反应
枞酸型树脂酸在一定温度下,经过催化剂作用,树脂酸分子间首先发生氢原子重排,枞酸型树脂酸通过双键重排而自由异构,形成枞酸。然后一部分枞酸的共轭双键上失去2个氢原子,形成具有稳定苯环结构的脱氢枞酸,另一部分枞酸分子则吸收2个或4个氢原子而生成二氢枞酸或四氢枞酸。
5)聚合反应
由于枞酸型树脂酸的共轭双键,在催化剂存在的条件下可以发生聚合反应,生成不同结构的二聚体。
6)氨解反应
松香或歧化松香在高温(280~340℃)和催化剂(或无催化剂)条件下进行氨解反应,树脂酸分子上的羧基和NH 3 作用,生成CN基。再在高压条件下加氢,可以生成NH 2 基。
7)酯化反应
树脂酸可以与多种醇类反应生成相应的酯,如甲酯、甘油酯、季戊四醇酯等。由于树脂酸羧基受到较高的空间位阻,使这一反应比脂肪酸酯化需要更高的温度和更剧烈的条件。这种阻碍特性决定了松香酯的键合很难被水、酸或碱所断裂。改性松香如氢化松香、聚合松香、歧化松香、马来松香等都存在羧基,同样可以生成相应的酯类产品。
8)还原反应
松香酸或酯在催化剂作用下,高压氢化还原,生成羟基。
9)成盐反应
树脂酸羧基与金属氢氧化物或氧化物反应可以生成钾皂、钠皂、钙皂等。树脂酸钠与金属盐反应,则可以得到钴盐、锰盐和铜盐等。另外,可以形成树脂酸胺盐,这对于各树脂酸分离具有重要意义。
10)氧化反应
树脂酸的氧化是个复杂的化学过程。一般认为,共轭共键在空气中会自行氧化,生成过氧化物或过氧氢化物。如果光敏氧化,则可以生成桥环过氧化物。